碳化硅和氮化镓为典型第三代半导体材料。
第三代半导体材料的特点:禁带宽度大、发光效率高、电子漂移饱和速度高、热导率高、硬度大、介电常数小、化学性质稳定以及抗辐射性能好、耐高温等。
因此,其在高亮度发光二极管、紫外—蓝光激光器和紫外探测器等光电子器件以及抗辐射、高功率、高频、高温、高压等电子器件域有着巨大的应用潜力和广阔的市场前景。
下面简要介绍碳化硅衬底种类
碳化硅衬底根据导电性来分,可分为半绝缘型衬底(电阻率大于1E5 Ω•cm)和导电型衬底。
其中,
导电型碳化硅衬底可用于生长碳化硅外延片,主要应用于制造耐高温、耐高压的功率器件如IGBT;
半绝缘型碳化硅衬底可用于生长氮化镓外延片,主要应用于微波射频器件等领域。
本文浅介绍碳化硅衬底常用测量手段。
一、晶圆几何参数测量
晶圆几何参数主要包括晶圆厚度、TTV、和BOW/Warp等,一般常用测试方法为光学干涉法和电容法。
★ 光学干涉法具有测试速度快,精度高的特点,设备价格昂贵,主要被Corning公司所采用,其Tropel系列被广泛应用于几何参数量测。
测量原理:掠入式干涉

主要厂商:Corning Tropel
★电容法几何参数测试仪相对成本较低,在硅片衬底中被广泛采用,对碳化硅衬底同样适用。
测量原理:电容测厚

主要厂商:MPI,E+H Metrology等
二、表面缺陷分析
碳化硅衬底的表面缺陷有表面颗粒、划痕和晶格缺陷等,主要采用碳化硅晶圆缺陷系统测试。
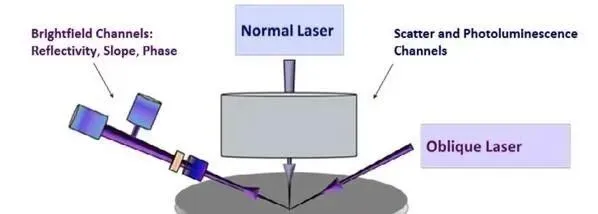
测量原理:电容测厚
利用激光在衬底表面的散射,可以分析衬底表面上的颗粒大小和缺陷形态,通过激光对衬底表面的面扫描,可以获得衬底上颗粒和缺陷的面分布情况,同时在光致发光(PL)功能模块的帮助下,可以进一步分析衬底内部的缺陷复合中心,为衬底质量评估提供更全面的信息。
主要厂商:KLA Candela,Lastertec, Horiba, Visiontec
三、表面粗糙度测量
表面粗糙度一般采用原子力显微镜(AFM) 和白光干涉仪(WLI)测量,可测试亚纳米级粗糙度。
AFM测试原理:
将一个对微弱力极敏感的微悬臂一端固定,另一端有一微小的针尖,针尖与样品表面轻轻接触,
由于针尖尖端原子与样品表面原子间存在极微弱的排斥力,通过在扫描时控制这种力的恒定,带有针尖的微悬臂将对应于针尖与样品表面原子间作用力的等位面而在垂直于样品的表面方向起伏运动。
利用光学检测法或隧道电流检测法,可测得微悬臂对应于扫描各点的位置变化,从而可以获得样品表面形貌的信息。
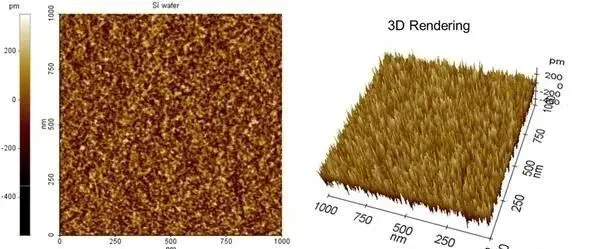
主要厂商:Bruker、Park System等
WLI测试原理:
基于白光干涉现象,通过分析被测表面与参考镜面反射光的光程差引起的干涉条纹变化,精确计算表面微观高度差,从而获取粗糙度参数。
主要厂商:Taylor Hobson、Bruker等
四、电阻率和掺杂浓度
- 导电型碳化硅的电阻率是通过涡流法进行检测的,导电线圈在导电衬底上形成涡流,涡流产生磁场变化被传感器侦测到,可以计算出衬底的方块电阻,涡流的检测原理如下:

主要厂家:Semilab,KITEC,Napon
- 半绝缘型碳化硅的电阻率是通过电容放电法进行检测的,设备为非接触高阻测试仪
测试原理:
电容探针法,在衬底上施加电压的瞬间,通过侦测电荷的变化,来计算衬底的电阻率。
应用:掺杂浓度,电阻率等
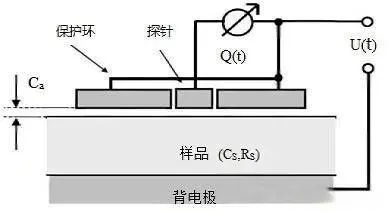
主要厂家:Semilab,EuroRad
五、晶型和结晶质量测试
晶型:不同结晶组分的碳化硅在衬底中的分布是通过对衬底面扫描获得Raman信号来实现的。
由于4H晶型和6H晶型的碳化硅具有不同的Raman信号峰,因此通过选定峰位范围的光强收集,可以区分出不同区域的晶型。

结晶质量:通过测量X射线摇摆曲线,获得衬底或者晶体某一晶面的衍射峰强度和角度分布,根据衍射信号半峰宽的大小来判定晶面间距的一致性,进而判定结晶质量。
六、位错密度和微管密度
要获取碳化硅衬底位错密度和微管密度分布的信息
- 首先在高温熔融氢氧化钾中腐蚀碳化硅衬底片,
- 然后在光学显微镜或者类似的光学成像系统中,进行分区域的图像识别,并计算单位面积(视场)的对应缺陷密度,由于不同的缺陷类型,如螺位错(TSD)、刃位错(TED)、基平面位错(BPD)和微管(MPD)有自己的典型图案特征,因此可以通过计算机图像识别加以区分。
主要设备为微分干涉显微镜。

总结
碳化硅衬底需要多种测量手段配合,这些测量手段不可或缺,通过监控产品质量进而不断改进工艺,提高产品良率,从而保证器件质量。
联系我们
- 苏州同创电子有限公司
- 电话:133 8218 2805
- 官网:www.sztcdz.com





